CMOS图像传感器发展史
CMOS(Complementary Metal-Oxide Semiconductor)图像传感器(CMOS Image Sensor,CIS)是一种用于捕捉图像的半导体设备,已经成为现代数码图像捕捉设备的主流。早期,CCD(Charge-coupled Device,电荷耦合器件)传感器由于其较高的图像质量和较低的噪声而被广泛采用,尤其是在高端应用如专业摄影和科学研究领域。1990年代初,CMOS传感器由于其制造成本低、功耗低和集成度高等优势,虽然最初的性能不如CCD,但CMOS的潜力逐渐显现出来。后来,随着制造工艺的进步,CMOS传感器的分辨率、低光性能、动态范围和响应速度都得到了大幅提升。这些改进使得CMOS传感器逐渐超越了CCD,在消费电子产品如数码相机、智能手机等中占据了主导地位。如今,除了传统的摄影和视频录制,CMOS传感器还广泛应用于安防监控、医学成像、自动驾驶汽车等领域。

图1 CMOS图像传感器
CIS的结构
CIS的结构主要包括前照式(Front Side Illuminated,FSI)CMOS、背照式(Back Side Illuminated,BSI)CMOS和堆叠式(Stacked)CMOS。FSI是最传统的CMOS传感器结构,其中感光元件位于电路层的上方。光路经过片上透镜、彩色滤光片,然后必须穿越金属排线层才能到达光电二极管。微透镜聚集光线,彩色滤光片分解光为RGB模式,金属排线层负责传输信号,但金属的不透光性会阻挡和反射部分光线,导致光电二极管接收到的光量减少,可能仅为70%或更少,这也可能引起像素间的串扰,影响色彩的准确性。背照式结构改进了前照式的限制,将电路层置于光电二极管之后,使光线可以直接到达感光元件。这种设计显著提高了光线的利用率,提升了低光环境下的成像质量,增加了传感器的灵敏度。堆叠式CMOS是索尼公司为移动终端开发的,其设计初衷是提高性能而非减小体积。这种结构通过在两个独立的芯片上分别制造像素区域和电路区域,然后将它们堆叠起来,解决了不同区域需要不同制造工艺的问题。这三种CIS结构各有特点,它们根据设计需求和应用场景的不同,提供了多样化的选择。
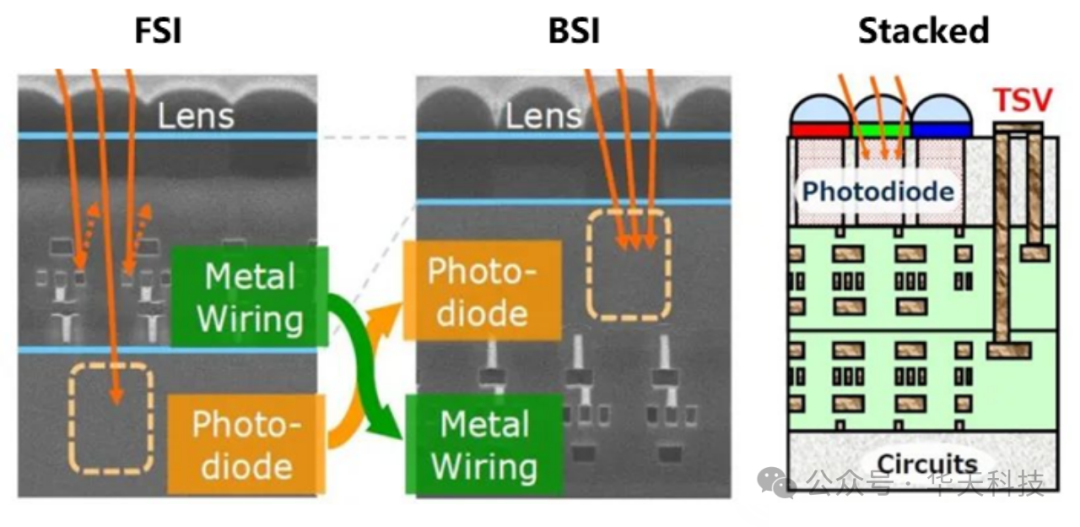
基于硅通孔的CIS晶圆级封装技术
半导体产业把高密度硅通孔(Through Silicon Via, TSV)技术广泛应用于CIS晶圆级芯片封装(Wafer Level Package,WLP),实现影像传感器与外部信号的互连。目前,华天科技(昆⼭)电⼦有限公司可以提供8英⼨和12英⼨基于TSV技术的全套图像传感器WLP结构,包括激光打孔技术,平⾯停留技术,半切技术和直孔技术。激光钻孔技术包括永久键合晶圆与带围堰的玻璃,减薄晶圆至预定厚度,形成双台阶,涂覆绝缘层,激光钻孔穿透绝缘层和金属Pad,溅射Ti/Cu种子层,金属重布线层,涂布阻焊层,印刷锡球,最终切割形成单颗封装的芯⽚。该技术的优点是流程相对简单,成本较低,但要求金属Pad下方不能有其他线路或功能设计,主要应用于消费类图像传感器封装。平面停留技术通过光刻使金属重布线层(Redistribution Layer, RDL)和金属Pad直接接触连接,提供更大的接触面积和更好的可靠性,解决了BSI/Stack Wafer不能打孔的问题。工艺流程包括涂布绝缘胶,去除Pad表层的二氧化硅绝缘层,后续制程与激光打孔工艺类似。UT半切技术(Ultra Thin Process)首先对晶圆背面进行研磨和干法蚀刻,再利用光刻和刻蚀工艺去除Pad上方的硅基,并在表面覆盖一层钝化胶。半切技术利用高速旋转的角度刀将Pad打开并切入键合胶层,然后进行重布线并制作引出端焊球,最终切割成单个封装体。UT技术可以增加线路和Pad的接触面积,同时避免激光打孔对Pad的损伤,节约成本,增加产品的可靠性。直孔结构封装技术是针对BSI和Stack等先进CIS结构设计的,可以处理具有Low-k材料的金属Pad。主要制程包括键合晶圆和玻璃,机械研磨,去应⼒刻蚀,刻蚀垂直通孔,PECVD沉积绝缘层,PVD沉积Ti/Cu种子层,电镀形成孔内线路。直孔技术可以满足I/O数目更多、可靠性要求更高、金属Pad结构更复杂的芯片封装需求。这些技术各自有其特点和适用场景,选择哪一种技术取决于产品的具体要求、成本效益分析以及制造工艺的可行性。
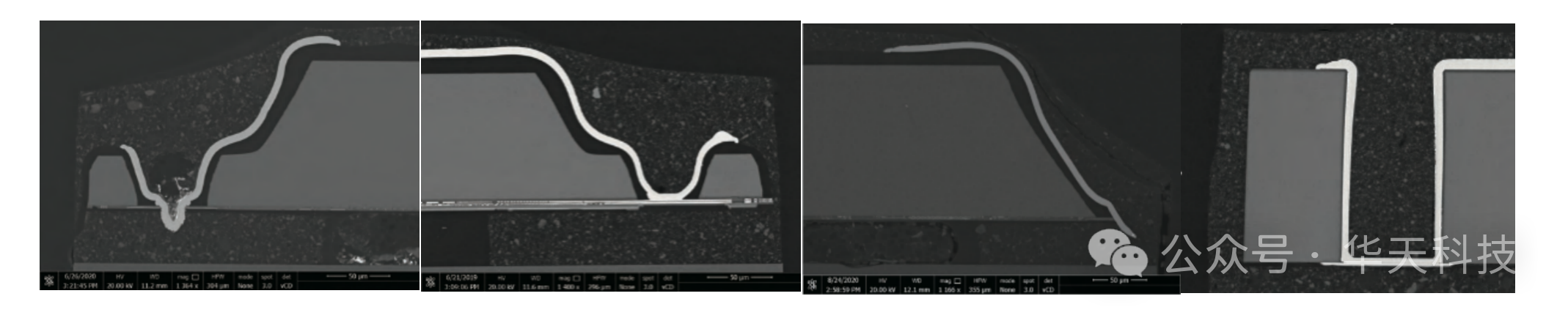
(1)激光钻孔技术;(2)平⾯停留技术;(3)UT半切技术;(4)直孔结构封装成品外观图和SEM 图
展望
基于TSV的CMOS图像传感器晶圆级封装技术在提升图像传感器性能和功能集成度方面具有显著优势。TSV技术允许在垂直方向上堆叠多个芯片层,实现芯片层之间的直接电连接,不仅显著提高了封装密度,减少了信号传输路径和延迟,还实现了CIS芯片的小型化。对于需要高速处理和高分辨率图像的应用,如专业摄影、视频监控和医疗成像,基于TSV的CIS封装技术能够提供更快的图像处理速度和更高的图像质量。尽管TSV封装技术在CIS中的应用前景广阔,但仍面临一些挑战。例如,TSV制造工艺复杂,成本较高,需要精确的制造和封装技术。此外,TSV的热应力管理、可靠性测试和量产能力也是需要解决的问题。未来,随着制造工艺的不断进步和成本的逐步降低,基于TSV的CIS封装技术将会更加成熟和普及。通过不断创新和优化,TSV技术有望在更广泛的应用领域中发挥重要作用,推动CIS技术的进一步发展和应用。









