
先进封装技术的迅猛发展正引领着产业变革的新浪潮。近日,华封科技联合创始人王宏波在“2024上海先导产业大会”上,深入剖析了先进封装技术的最新前沿趋势,分享华封科技在这一领域的最新成果与创新思考。
作为一家在高端装备制造领域深耕多年的企业,华封科技以其在先进封装设备领域的卓越成就,成为了全球半导体产业链中不可忽视的力量。面对海外巨头的竞争,王宏波直言:“我们与海外竞争对手,实际呈现‘犬牙交错’的状态,某些方面处于绝对领先地位,某些方面紧紧跟随。例如在晶圆级封装领域,华封科技在市场上展现出领先姿态,在台湾日月光已有超过70台的量产装机量,超过80%的高通5G芯片由此产出。此外,华封科技在板级封装领域也已助力客户走向量产。”
今年上半年,华封科技发布了A系列新机——AvantGo A2(仙女座),这是一台拥有1.5um超高精度的晶圆级贴片设备,同时具备业界领先的超快产出速度(UPH高达3.5K)。王宏波表示:“华封科技是一家以创新为驱动力的设备公司,同时也是一家‘服务型’公司,致力于服务好每一家客户,让客户因为华封的产品而获得大幅成长。”
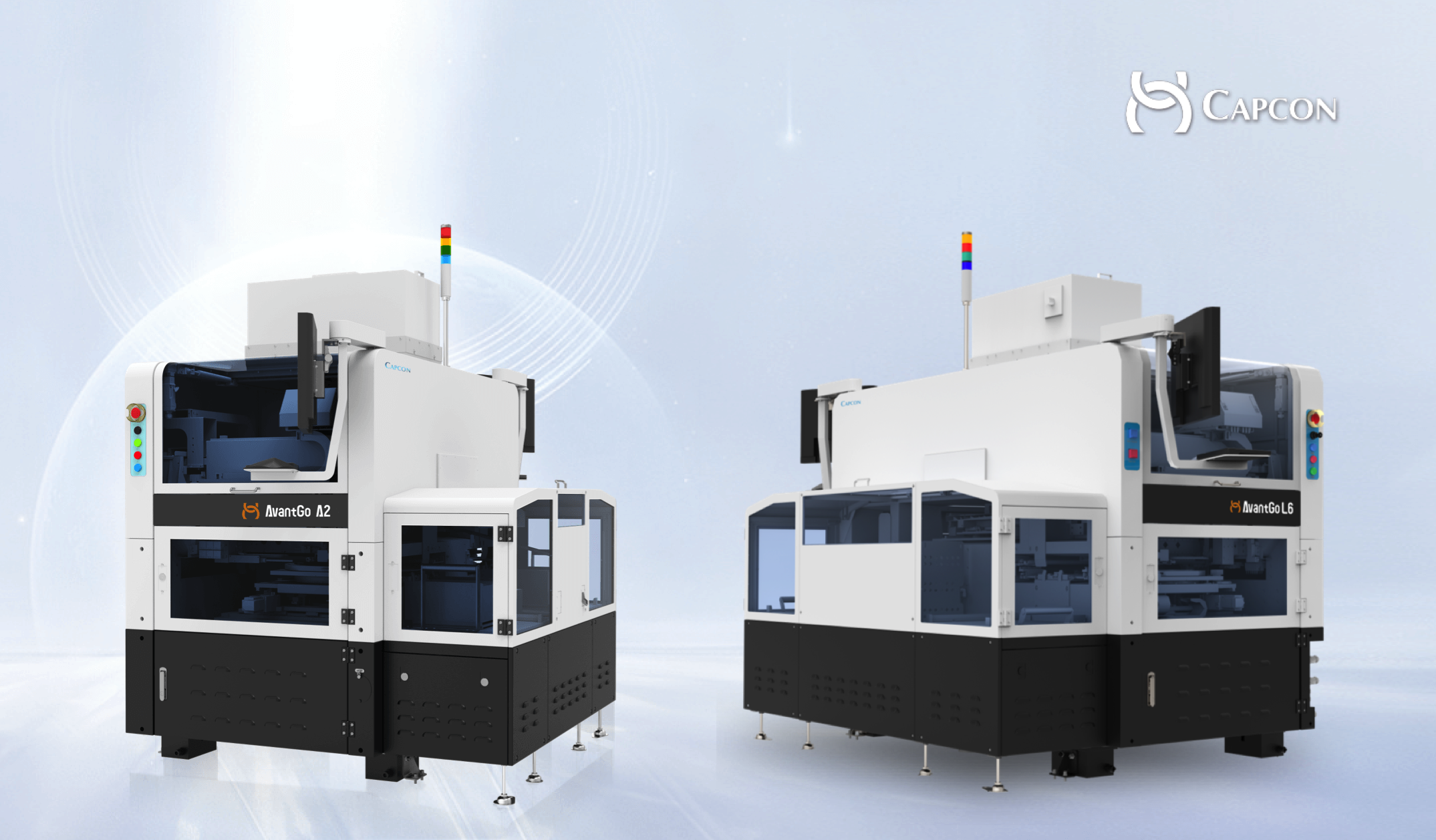
AvantGo A2(仙女座)(左)和AvantGo L6(狮子座)(右)
除了超高精度的A系列和晶圆级的2060系列外,华封科技近年来也在板级封装领域开始发力,推出了L系列的多款产品。其大面板级封装贴片机AvantGo L6(狮子座)自发布以来便捷报频传,目前已获得多家国际头部IDM厂商批量采用并开始大规模量产。
根据集微网此前报道,AvantGo L6设备可前后机同时作业,最大支持700mmx750mm载盘冷、熟焊接;拥有高精度(±5μm@3σ,±0.005°@3σ)、高速度(12k UPH)双动梁多键合头;支持最大100mm×100mm芯片正反贴装;独立双晶圆台同时处理多种芯片;占地面积最小至1480 x 2020 x 1870mm。
AvantGo L6领先的技术指标在很大程度上满足了面板级封装增大载板尺寸,提高工作效率,保证一致稳定,提升精度等要求,在性能和指标上将面板级封装的能力提升至一个新的水平。
此外,据了解,AvantGo系列产品也获得某头部存储器厂商采用,用于最新制程下的HBM产品迭代。作为HBM后道工艺中最关键的核心设备,贴片机对超高精度、快速对准和定位以及连续贴片等有着极为严苛的要求。以后起之秀的身份率先获得HBM厂商在最新产品平台的采用,意味着经过短短几年的发展,华封科技已然实现了从追赶到引领的跨越。
创新与服务,如何引领发展
关于为何华封科技能够引领高精度贴片机技术发展,集微网曾与华封科技顾问、日月光原高级副总裁杜嘉秦博士展开讨论。杜博士指出,相比于封装技术的创新,设备的创新要更加前置才能捕获市场。例如从市场情况来判断,今年下半年最先进的封装技术对贴片机精度的要求才会下探到1.5μm级别,但华封科技在今年第一季度便推出满足客户要求的AvantGo A2,再加上此前经历的开发和验证周期,华封的创新要优先于整个市场的需求走向。

华封科技顾问、日月光原高级副总裁 杜嘉秦博士
王宏波强调,先进封装目前已经是整个半导体领域创新最多、投资最集中的细分领域,无论是晶圆代工厂、EDA公司、IC设计公司还是封装厂和设备厂,都在积极地投资和拥抱先进封装。这些创新对封装设备商提出了越来越多的灵活性需求,而封装设备公司就是通过技术创新来满足这些需求,从而推动整个半导体领域继续向前发展。
当然,除了创新之外,杜嘉秦博士还强调,封装设备公司要以服务客户为第一要义。例如多年来华封科技在多晶片贴片(Multi-Chip Die Bond)领域的创新和投入,正是因为大多数客户都对此抱有超高的期待。
由于芯片与芯片之间、有源器件和无源器件之间对贴片精度和夹具尺寸的要求各不相同,因此在传统封装产线中,往往需要在单一芯片贴片后通过机械手臂传递到下一台设备中完成另一次贴片,这不仅带来了超高的时间成本和资金成本,在传递过程中也会对良率造成一定影响。而如果采用多晶片贴片机,则能帮助客户更快地将产品推向市场。
据介绍,华封科技是业内第一家推出多晶片贴片机的封装设备商,目前已经在精度和UPH层面领先同行。此外,为了更好地服务客户,华封科技每年在售后端投入了巨大的精力和资金。因为在客户切换产品时需要用到不同的贴片头(Bond Head),以日月光为例,仅一家客户每年需要的Bond Head种类就可能达到1000种以上。
市场井喷,如何扩大优势?
当下,包括工业4.0、自动驾驶、超级计算机、VR、卫星通讯、人形机器人以及脑机接口在内,这些产业加起来的规模将达到30万亿美元级别,而这些产业发展的主要推动力之一就是半导体。随着摩尔定律逐渐失效,先进封装的重要程度日益凸显。

根据Yole数据,受5G、AI、HPC等因素影响,2022年全球封装市场规模约为950亿美元,其中先进封装市场规模为443亿美元,占比47%;预计到2028年,全球封装市场规模将达到 1433亿美元,其中先进封装市场规模786亿美元,占比55%。
虽然目前台积电等晶圆厂玩家仍在先进封装领域占据了不小的份额,但杜嘉秦博士认为,台积电至少有50%的先进封装订单将会外溢到OSAT,该公司资本开支的重心会优先在先进工艺的开发和建厂之上。因此,华封科技将随着OSAT厂商扩产迎来巨大的发展机遇。
早在2021年时,台积电便开始将CoWoS封装业务的部分流程外包给了日月光、矽品、安靠等OSAT,尤其是在小批量定制产品方面。对于一些需要小批量生产的高性能芯片,台积电只在晶圆层面处理CoW流程,而将oS流程外包给OSAT,类似的合作模式在其3D IC封装中也同样存在。
不仅市场需求和空间在不断上扬,先进封装本身的经济效益也节节攀升。以英伟达的H100芯片为例,据业内人士透露,这颗超高算力的GPU芯片总价约为3000美元,其中晶圆制造成本只占200美元,而先进封装的成本则达到723美元,大约是晶圆制造的3.6倍。
不难看出,先进封装市场空间将会呈现井喷式发展。而在这样的背景下,华封科技需要继续在技术创新和产品线拓宽层面展开大量投资。据悉,华封科技在全球范围内联合业内多家厂商和机构于横琴建立半导体先进封装实验室。该实验室将致力于解决行业内最具影响力且最为普遍的问题,实现中试线的试点运行,进而推动我国在先进封装领域取得领导地位,最终成长为全球集成电路产业技术策源地的第四极。
据悉,该实验室项目以前沿技术的落地为主要导向,华封科技将通过帮助客户与合作伙伴建设新工艺中试线的方式进一步加强与产业界的紧密联系。以专利、工艺授权以及代工设计等多种形式促进科研成果的商业化进程,加速客户的技术进步,为半导体产业的发展作出积极贡献。
资料显示,横琴实验室项目具有同全球三大实验室同步的研发水平,引领产业快速发展;整个项目建成后,不仅能聚集完整产业集群,而且还能补齐产业短板。项目以最前沿且最实用的技术作为牵引,以实验室及新工艺中试线作为重要载体,培养出一批能够熟练掌握先进技术的高端人才,为产业的高质量发展提供强有力的支撑。