
集微网报道,作为延续摩尔定律的重要途径之一,先进封装技术受到了业内的重视。包括代工厂、基板/PCB供应商、EMS/ODM等不同商业模式的厂商们纷纷加入战局。值得注意的是,今年开春以来,关于先进封装的报道屡见报端。结合过往和未来关于先进封装的种种动态,我们或可预测,先进封装的黄金时代,即将到来。
过去:真金白银投入
先进封装主要是指倒装(FlipChip),凸块(Bumping),晶圆级封装(Waferlevelackage),2.5D封装(interposer,RDL等),3D封装(TSV)等封装技术。先进封装在诞生之初只有WLP,2.5D封装和3D封装几种选择,近年来,先进封装的发展呈爆炸式向各个方向发展,而每个开发相关技术的公司都将自己的技术独立命名注册商标,如台积电的InFO、CoWoS,日月光的FoCoS,Amkor的SLIM、SWIFT等。

相比传统封装,一方面,先进封装技术效率高;另一方面随着芯片向着更小、更薄方向演进,先进封装技术均摊成本更低,可实现更好的性价比。先进封装的优势也是业界对其委以重任的重要原因。
据Yole Developpement最新的2021年年度高端封装报告,行业龙头在先进封装上的资本支出约为119亿美元。其中,英特尔以35亿美元的资本支出排名第一,主要用以支持Foveros和EMIB技术;台积电则以30.5亿美元的资本支出排名第二,其正在为3D片上系统组件定义新的系统级路线图和技术,其CoWoS平台提供硅中介层,LSI平台则是EMIB的直接竞争对手;日月光以20亿美元的资本支出排名第三,其是最大也是唯一能够与代工厂和集成设备制造商形成竞争的OSAT,凭借其FoCoS产品,日月光也是目前唯一拥有超高密度扇出解决方案的OSAT。三星以15亿美元的资本支出排名第四,公司也有类似于CoWoS的I-Cube技术。此外,中国大陆长电科技、通富微电也上榜。

来源:Yole
现在:热度持续升温
过去的一年,行业龙头在先进封装上投入了切切实实的真金白银,而今年关于先进封装的热度不减,且有持续升温之势。
今年3月俨然成了“先进封装月”。3月3日,就率先迎来涉及先进封装的重磅消息。英特尔、台积电、三星和日月光等十大巨头宣布成立通用芯片互连标准——UCIe,将Chiplet(芯粒、小芯片)技术标准化。这一标准同样提供了“先进封装”级的规范,涵盖了EMIB和InFO等所有基于高密度硅桥的技术。
10日,苹果发布了M1 Ultra芯片,有业内人士认为,该芯片采用了台积电的CoWoS-S(chip-on-wafer-on substrate with silicon interposer)封装工艺。
14日,三星电子在DS(半导体事业暨装置解决方案)事业部内新设立了测试与封装(TP)中心。韩媒认为,该中心的设立和人员调整,或意味着三星电子将加强先进封装投资,确保在后端领域上领先于台积电。
17日,英特尔宣布在欧盟投资超过330亿欧元,除了芯片制造外,还将在意大利投资高达45亿欧元的后端制造设施。据悉,该工厂将“采用新技术和创新技术”为欧盟提供产品。
21日,台积电借由整合型晶圆级扇出封装(InFO)与前段先进工艺的一条龙服务,成功拿下苹果iPhoneA系列处理器多年独家代工订单。据了解,台积电的InFO_PoP封装技术已进入第七代,除苹果外,并将吸引包括高通和联发科在内的主要安卓智能手机SoC供应商的订单。
30日,在华为2021年年度业绩发布会上,华为轮值董事长郭平表示采用芯片堆叠技术以面积换性能,用不那么先进的工艺获得更强的性能,确保华为的产品具有竞争力,如此可以说是正式确认了华为正在推进芯片堆叠技术。集微网对此分析认为,在先进制程产能无法获取的情况下,先进封装,几乎是华为在高性能半导体器件上突围的一张“明牌”。紧接着4月初,华为便公开了“一种芯片堆叠封装及终端设备”专利。
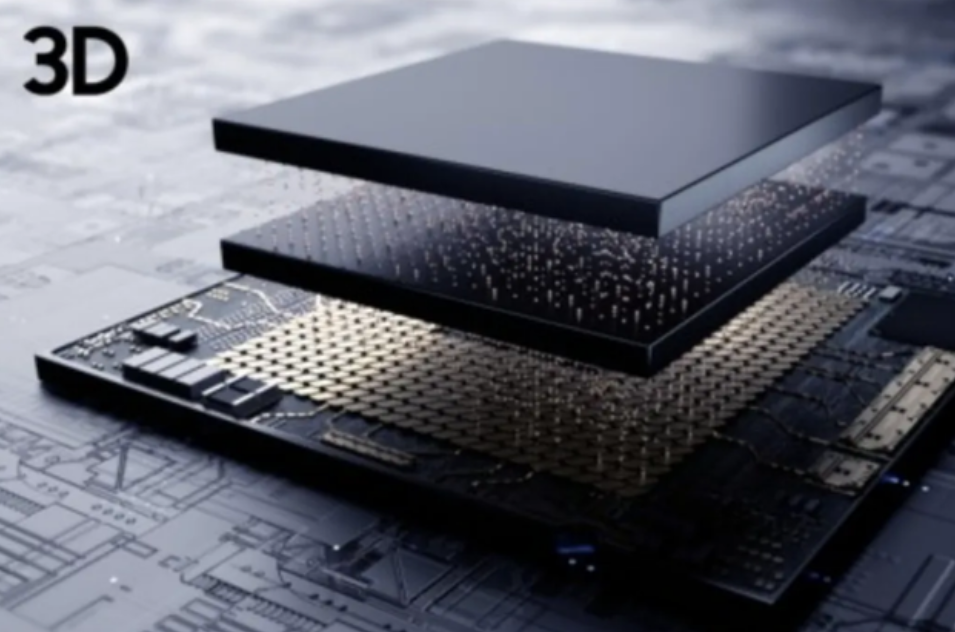
4月11日,有消息称美商务部推进先进封装技术发展规划。据报道,美国商务部国家标准与技术研究院 (NIST) 先进制造办公室已选中半导体研究公司(SRC)为承包商,在未来 18 个月内为微电子和先进封装技术 (MAPT)编制路线图,SRC公司表态称,先进封装以及3D单芯片和异构集成将成为下一次微电子革命的关键推动力。事实上,先进封装正在成为2D摩尔定律时代的晶体管缩放替代路线。
总结来看,先进封装已经成为半导体中越来越普遍的主题。
未来:产品大量落地,将迎大爆发
事实上,从各大厂商的未来的发展布局中也能看出,在不远的将来,随着先进封装产品的相继落地,先进封装或迎来真正的爆发。
近日,美系外资最新报告指出,预估英伟达Hopper和超微RDNA 3的GPU都将在今年开始采用2.5D封装技术。而为满足英伟达强劲的订单需求,台积电今年对散热、底部填充和焊剂材料以及CoWoS应用基板的采购可能会增长三倍。
此外,据爆料苹果2022年新款iPhone的A16 AP将采用台积电的InFO_PoP封装技术,联发科手机AP则将于2023年采用台积电InFO_B方案。
英特尔预计2022年上半上市的Ponte Vecchio GPU将采用Co-EMIB封装技术。另外,英特尔Meteor Lake CPU预计2022年下半进入量产,2023年上半上市。据DIGITIMES Research观察,Meteor Lake CPU将采用Foveros Omni技术,是首个采3D封装技术的主流CPU。
超微2022年下半推出的Zen 4架构CPU将采台积电的SoIC方案(为混合键合技术)。混合键合相对微凸块拥有更小的芯片焊垫间距(pad pitch)与更高的I/O密度,提升HPC芯片性能。
联发科HPC产品将朝向Chiplet架构发展,预计2023年上市,届时将采用台积电InFO_oS方案;而到了2024年,将导入混合键合技术,采用台积电3D Fabric平台。
在今年1月半导体投资联盟、爱集微共同举办的“2022第三届半导体投资联盟年会暨中国IC风云榜颁奖典礼”上对华封科技联合创始人王宏波采访中,他就曾分析说,2022年将是先进封装的爆发年,已经普及的先进封装工艺如FC倒装将继续蓬勃发展,中国大陆将是主战场;目前在国际上应用比较少的晶圆级封装将首先在中国台湾、韩国等海外市场迎来黄金发展期并进行大量的扩产,而大陆市场也将加快追赶的脚步,在技术上迎头赶上,从研发阶段逐步进入到小批量量产阶段;先进封装工艺也将继续开枝散叶,各种新的先进封装工艺将被研发出来,3D、ChipLet、SiP 各种方向新工艺将层出不穷、百花齐放。
根据Yole数据,2020年全球封装市场规模微涨0.3%,达到677亿美元。而按推算,2021年全球封装市场规模约上涨14.8%,约达777亿美元。根据Yole预计,2021年先进封装的全球市场规模约350亿美元,到2025年先进封装的全球市场规模约420亿美元,2019-2025年全球先进封装市场的CAGR约8%,相比同期整体封装市场(CAGR=5%)和传统封装市场,先进封装市场的增长更为显著,将为全球封装市场贡献主要增量。
未来,物联网、汽车电子和高性能计算等新兴应用有望持续打开先进封装的成长空间。先进封装的黄金时代,即将来临!
(校对/holly)


 登录
登录








